

0-2000°C ИСПОЛЬЗОВАТЕЛЬНЫЙ МАТЕРИАЛ И ЛИДЕР ОТГРЕВЛЕНИЯ
Запросите бесплатную консультацию Запросите техническую поддержку
Электронная почта

Тел

WhatsApp/WeChat
Свяжитесь с нами
Все продукты настраиваемы, оставьте сообщение немедленно, мы ответим как можно скорее.


Система химического осаждения из паровой фазы (CVD)
Система химического осаждения из газовой фазы (CVD) состоит из системы нагрева, вакуумной системы, газосмесительного устройства и системы управления. Система использует ПИД-регулятор температуры, что обеспечивает высокую точность поддержания температуры, отличную точность расхода газа, простоту эксплуатации, отличную теплоизоляцию и равномерность температуры. Система в основном используется в университетах, исследовательских центрах и на производственных предприятиях для экспериментов и производства, связанных с осаждением из газовой фазы.
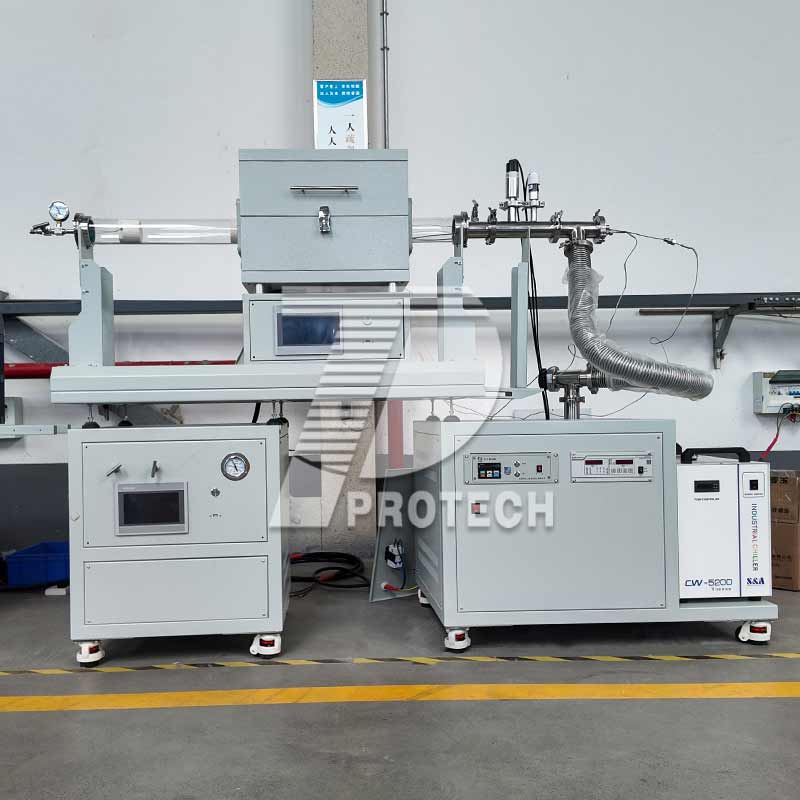
Система плазмохимического осаждения из паровой фазы (PECVD)
Оборудование для PECVD состоит из трубчатой печи, источника высокочастотного питания плазмы, вакуумной системы, системы газового тракта и системы управления. Оно может смешивать от 1 до 6 газов для PECVD или диффузии. Система использует источник высокочастотного питания для перевода газов в вакуумной камере в ионное состояние. Плазма обладает высокой химической активностью и легко реагирует, осаждая желаемую тонкую пленку на подложке. Пленки, осажденные методом PECVD, обладают превосходными электрическими свойствами, хорошей адгезией к подложке и очень хорошим покрытием ступеней. Они в основном используются для таких экспериментов, как рост графена, рост двумерных материалов, осаждение карбида кремния, тестирование проводимости керамических подложек, контролируемый рост наноструктур ZnO и атмосферное спекание многослойных керамических конденсаторов (MLCC).

Оборудование для химического осаждения из газовой фазы широко используется в следующих областях:
Осаждение тонких пленок: используется для осаждения различных тонких пленок, таких как пленки оксидных, нитридных и карбидных соединений, включая диоксид кремния (SiO₂), нитрид кремния (Si₃N₄) и оксид цинка (ZnO).
Подготовка наноматериалов: используется для выращивания двумерных материалов, таких как углеродные нанотрубки и графен.
Вакуумное спекание в атмосфере: используется для процессов химического осаждения из газовой фазы или диффузии, включая широкий спектр изоляционных материалов, а также большинство металлических материалов и металлических сплавов, двумерных материалов, таких как покрытие из карбида кремния, испытание проводимости керамических подложек и атмосферное спекание керамических конденсаторов (MLCC).
Технические параметры
| имя | ССЗ/ПХВД | ||
| модель | PT-CVD1200 / PT-PECVD1200 | PT-CVD1400 / PT-PECVD1400 | PT-CVD1700 / PT-PECVD1700 |
| самая высокая температура | 1200℃ | 1400℃ | 1700℃ |
| Рабочая температура | 1100℃ | 1300℃ | 1600℃ |
| нагревательный элемент | провод сопротивления | стержни из карбида кремния | кремний-молибденовый стержень |
| термопара | N-типа | S-образный | Тип Б |
| Наружный диаметр трубы печи | φ40~φ100 мм |
φ60~φ100 мм |
φ60~φ100 мм |
| Длина зоны нагрева |
200~440 мм |
300~440 мм |
300~440 мм |
| Количество температурных зон | Однозонный или многозонный, выбирается в соответствии с потребностями заказчика. | ||
| Другие размеры могут быть изготовлены по индивидуальному заказу в соответствии с требованиями заказчика. | |||
| Метод контроля температуры | ПИД-регулирование и самонастройка, интеллектуальное 30-сегментное программируемое управление | ||
| Защита контроля температуры | Функция защиты от перегрева и поломки термопары | ||
| скорость нагрева | Рекомендуемая температура: 0~10°C/мин | ||
| Точность контроля температуры | ±1℃ | ||
| рабочий блок питания | 220/380 В, 50 Гц (настраивается по запросу) | ||
| Материал печи | Высокочистое огнеупорное волокно из оксида алюминия | ||
| Конструкция кожуха печи | Корпус из углеродистой стали, двухслойная оболочка, оснащен системой воздушного охлаждения. | ||
| Конструкция корпуса печи | Горизонтального типа, с опциональной открывающейся/герметичной дверцей печи. | ||
| Вакуумная система | Пластинчато-роторный насос/диффузионный насос/молекулярный насос (опционально) | ||
| Абсолютный вакуум | ≤6,67* 10-3Па (пустая печь, холодное состояние, после очистки) | ||
| Расходомер | Поплавковый расходомер/расходомер протонов, опционально | ||
| Система охлаждения (опционально) | охладитель воды | ||
| Другие дополнительные конфигурации | Сенсорный экран, дистанционное управление , дисплей компьютера | ||
| Размеры ( наружный диаметр трубы печи * длина зоны нагрева ) | Модели HL-CVD1200/ HL-PECVD1200 | Модели HL-CVD1400/ HL-PECVD1400 | Модели HL-CVD1700/ HL-PECVD1700 |
|
φ40*200мм φ50*200мм φ60*300мм φ80*300мм φ100*300мм φ60*440мм φ80*440мм φ100*440мм |
φ60*300мм φ80*300мм φ100*300мм φ60*440мм φ80*440мм |
φ60*300мм φ80*300мм φ100*300мм φ60*440мм |
|
|
Многотемпературные зоны φ60*220*220мм φ80*220*220мм φ100*220*220 мм φ120*220*220 мм φ60*220*220*220 мм φ80*220*220*220 мм φ100*220*220*220 мм φ120*220*220*220 мм |
Многотемпературные зоны φ60*220*220мм φ80*220*220мм φ100*220*220 мм φ60*220*220*220 мм φ80*220*220*220 мм φ100*220*220*220 мм |
Многотемпературные зоны φ60*220*220мм φ80*220*220мм φ100*220*220 мм φ60*220*220*220 мм φ80*220*220*220 мм φ100*220*220*220 мм |
|
| Другие размеры могут быть изготовлены по индивидуальному заказу в соответствии с требованиями заказчика. | |||
Указанные выше параметры могут быть скорректированы в соответствии с требованиями технологического процесса и не должны служить основанием для принятия решения. Преимущественную силу имеют конкретное техническое решение и соглашение.
